产品信息
上海合晶的半导体硅外延片之所以受到国内外客户的广泛认可,主要是因为产品的一体化生产,同时掌握晶体成长、硅片成型与外延生长三大工艺技术,相辅相成,互相补强,以实现高质量的外延层。抛光片的技术对本公司的竞争力影响甚巨。
 |
产品参数 直径: 125/150/200 mm 外延掺值: P型;N型 掺杂剂 / 电阻率范围 (ohm-cm) : 硼(B) 0.0005 ~ >1000 磷(P) 1~100 紅磷(RedP) 0.0009 ~ 0.0015 砷(As) 0.0019~0.007 锑(Sb) 0.007~0.025 晶向: (111), (100) |
工艺介绍
抛光片主要分成两大关键工艺,晶体成长技术及硅片成型技术。
|
晶体成长技术 单晶生长技术的重点在于保证拉制出的硅单晶棒在保持极高纯度水平的同时,能有效控制晶体缺陷的密度,从而减少用其所制成的硅片的缺陷数量。长期以来,仅日本及欧美少数硅片厂商具备生产超低缺陷硅单晶棒的技术能力,而上海合晶为国内少数能独立自主开发出超低缺陷硅单晶棒成长技术的厂商之一。
我们以CZ法进行晶圆(100)及(111)单晶成长,掺入P型硼原子或N型磷、砷、锑原子控制电阻率,结合完善的长晶热场系统,综合搭配压力、流量、温度的特定工艺设定,来调节RRG、氧含量、ORG、微观缺陷等相关参数,来满足客户产品需求,实现超低电阻晶棒的生长,使功率器件的导通电阻值降低,更是使用重掺杂的衬底的外延片极其重要的贡献之一。 |
 |
|
硅片成型技术 硅片是半导体组件的基础,其质量对半导体器件的组建有决定性的影响。硅片加工主要包括晶棒切片、硅片倒角、硅片研磨、硅片腐蚀、晶背加工、硅片抛光、硅片清洗、硅片检测及包装等多个工序。 |
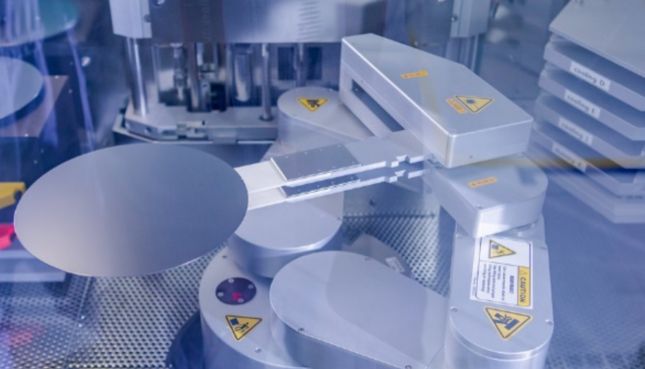 |
 |
晶棒切片 以切割机将晶棒切成具有精准几何尺寸之硅片,并利用机台相关参数的调整来控制硅片的翘曲度与应力分布。 |
 |
硅片倒角 硅片切片后其边缘通常具有锐角以及微小损伤,此制程能有效地将硅片边缘损伤移除并达到一定程度的细致化,而适合的倒角有助于消除将来抛光片或外延片于电路制作过程中破损的可能性。 |
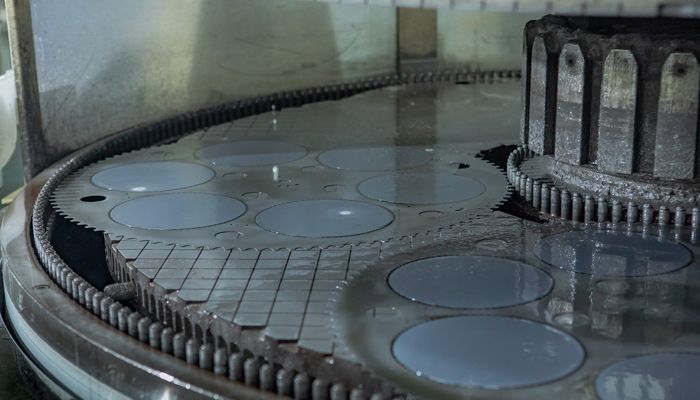 |
硅片研磨 为影响晶圆产品翘曲度、平坦度、厚度均匀性之关键制程。切片制程會造成硅片表面损伤,因此利用此制程进行加工处理,以移除上述损伤层。 |
 |
硅片腐蚀 硅片在经过切片和研磨后,表面因机械加工应力会形成一层损伤层,蚀刻制程是利用适当配比之酸性或碱性溶液,在精确的温度控制范围内,以化学反应移除表面损伤层。 |
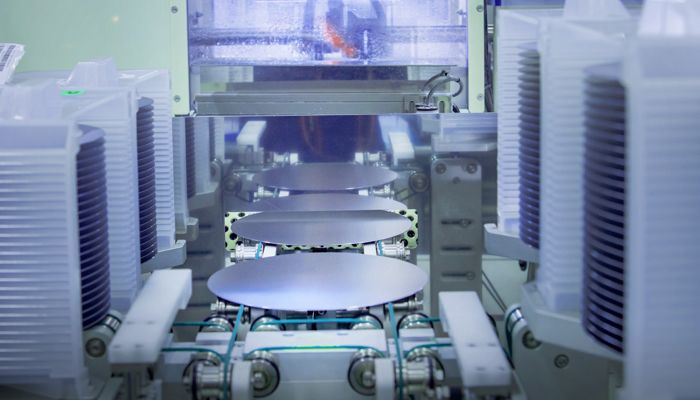 |
晶背加工 晶背加工包含喷砂、多晶硅薄膜及二氧化硅薄膜三种制程,这三种晶背加工制程,可依据不同需求进行搭配。其中,喷砂及多晶硅薄膜具有外部吸杂效果;,二氧化硅能抑制外延生长过程中的自掺杂效应。 |
 |
硅片抛光 利用化学机械研磨方式,将晶圆的蚀刻面平整化为奈米级平滑度,并兼顾硅片的翘曲度、平坦度等各项指标,避免硅片在高端用途中微影蚀刻制程中遭遇到问题。 |
 |
硅片清洗 去除硅片表面的各种污染物,例如:表面微尘颗粒、有机物、金属等各种可能的污染。 |
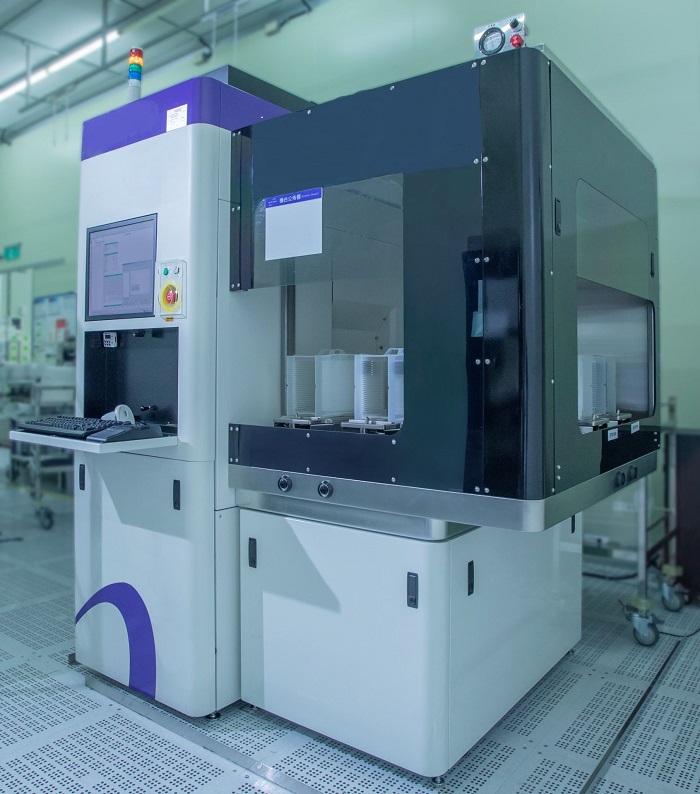 |
硅片检测 硅片以设备量测其电阻率、厚度、平坦度、翘曲度等物理特性值后进行最終清洗,再以高精密度的设备检测其表面微尘颗粒、有机物、金属等缺陷项目,确保硅片质量符合客户需求。 |
 |
包装 以硅片盒盛装硅片后,经由包装制程于硅片盒外包覆PE袋及铝箔袋,使其在保存及运送途中,不会被环境、外力等因素破坏质量。 |
产品应用
我司一体化外延,可根据不同衬底的掺值及阻值,搭配相对应的外延参数,达成客户高度客制化需求,可用于功率器件、CIS等模拟电路用产品生产。
